|
|
|
В.Ю. Татур
Проект «МИССИЯ», о котором я писал в статье «15 лет проекту «СКИФ»: история и итоги», не был бы сформулирован без технологий Александра Ивановича Тарана. Его подпроект, обладающий несомненной самоценностью, был один из основополагающих для всей программы. Он не был идеей, как и все те технологии, которые составляли основу проекта «МИССИЯ». Это был прорыв в микросборке электронных изделий, который превращал очень дорогостоящую и технологически сложную процедуру бескорпусной сборки электронных устройств, в простое, дешевое, технологичное и автоматизированное производство. Это был подарок России, от которого она отказалась в лице всех тех, кто принимает решения в Министерстве обороны, в компаниях по производству микроэлектронных изделий и т.д. Там, где что-то дешевле – своровать сложнее, откаты меньше. Технологичность и дешевизна технологии А.И. Тарана в России превратились в непреодолимое препятствие для ее применения.
Микроэлектроника до А.И. Тарана
Как известно, вся элементная база и компоненты (интегральные схемы, резисторы, конденсаторы и т.п.) создаются и производятся для их физического связывания, в процессе сборки аппаратуры, в электрические схемы, реализующие разные полезные функции.
Сборка аппаратуры обладает той уникальной особенностью, что именно она синтезирует элементную базу различных поставщиков и электрические функциональные схемы различных разработчиков в товарный продукт.
Главными компонентами электронной аппаратуры в конце 90-х гг и в начале XXI века, да и пожалуй до сих пор, являлись Интегральные Схемы (ИС), состоящие из кристаллов ИС, заключенных в защитные корпуса.
|
характеристики кристаллов ИС |
значения |
|
размеры кристаллов |
до 4 см2 |
|
минимальные размеры элементов на кристалле ИС (толщина человеческого волоса ~ 100 мкм) |
< 0,13 мкм |
|
количество выводов на кристалле |
до 1500-2500 |
|
тактовые частоты |
до 4 ГГц (2х109 Гц) |
|
энергопотребление |
до 70-100 Вт |
Современные способы сборки аппаратуры, основанные на использовании корпусированной элементной базы, задают определенные стандарты на габариты и функциональную плотность аппаратуры в линейке конструктивов:
ТЭЗ (Типовой Элемент Замены): размеры ~2х20х30см» 1литр, в котором размещен «активный» (функциональный) кремний (АК) суммарной площадью ~3-5см2, т.е. плотность упаковки в ТЭЗ ~5-10см2 АК/литр.
Блок (в блоке ~20 ТЭЗ – 100-200см2 АК): размеры блока ~30х40х40см» 50литр, плотность упаковки ~2-4см2 АК/литр.
Стойка (в стойке ~5 блоков – 500-1000см2 АК): размеры стойки ~40х80х180см» 600литр (с учетом источников питания, вентиляторов и т.п.), плотность упаковки ~1-2см2 АК/литр.
Таким образом, можно констатировать, что итоговая плотность сборки (т.е. упаковки «активного» кремния, который, собственно, и выполняет требуемые функции над поступающей информацией) в современной стандартной аппаратуре (например, в конструктиве «Евромеханика») весьма невысока.
Причиной этого является то, что сборка производится из элементной базы, упакованной в индивидуальные корпуса, что приводит к большим массогабаритам аппаратуры, поскольку при корпусировании размеры и вес используемых ИС увеличиваются в разы. Кроме того, корпусирование существенно удорожает исходные кристаллы ИС (до 10 раз относительно кристаллов на пластине), не говоря уж о трудностях с индивидуальными корпусами для современных кристаллов ИС (например, корпуса для кристаллов Pentium или AMD – это «произведения искусства» и в изготовлении, и в сборке).
Всем известно, что интегральные схемы в индивидуальных корпусах используют для монтажа на печатные платы. Эти коммутационные печатные платы представляют собой многослойные и дорогие конструкции. После монтажа корпусированных ИС на эти платы, начинаются проблемы из-за корпусов, связанные с потерей быстродействия соединяемых между собой кристаллов ИС, плохим соотношением сигнал/шум в запутанных межсоединениях, с повышением тепловыделения и с охлаждением ИС и т.д.. При этом габариты, вес и стоимость узлов аппаратуры на печатных платах с корпусированными ИС становятся совсем неприемлемыми в свете современных требований к аппаратуре.
Радикальным выходом был переход к аппаратуре, собранной из бескорпусных кристаллов ИС, в виде т.н. МногоКристальных Модулей (МКМ), в которых накладные расходы на общий корпус делятся между всеми кристаллами в этом корпусе. При этом, в принципе, снижается себестоимость сборки в пересчете на один кристалл. А габариты, вес, надежность и прочие свойства МКМ-аппаратуры улучшаются в десятки раз. МКМ-аппаратуру отличает высокая плотность упаковки ( >100см2 АК/литр).
Но все это – при наличии коммерческой (т.е. массово воспроизводимой и недорогой) МКМ-технологии.
Для того чтобы смонтировать кристалл ИС в индивидуальный корпус или в составе многокристального модуля, надо электрически и механически (прочно!) соединить контакты кристалла с ответными контактами корпуса или коммутационной структуры (платы) МКМ.
Известно много МКМ-технологий сборки плотноупакованной аппаратуры. Все они, так или иначе, опираются на конструкцию и способ формирования Контактных Узлов (КУ – два контакта, связанных между собой электрически и механически через посредство соединительного элемента).
Все преимущества и проблемы сборки вытекают из конструкции Контактного Узла, т.е. существенно зависят от взаимного расположения соединяемых контактов и устройства соединительного элемента.
В настоящее время в отрасли имеется две господствующие технологии сборки чипов в корпуса или в многокристальные модули: Wire Bond и «Flip Chip»
Wire Bond
Два сопряженных контакта, «смотрящих» в одну сторону и связанных приваренной проволочкой, образуют сварной КУ (Wire Bond). Этот КУ используется в сборке с конца 50-х годов, хорошо отработан и обеспечен материалами и оборудованием. За последние 60 лет в инфраструктуру Wire Bond технологии сборки были вложены сотни миллиардов долларов, что определяет высокий уровень качества и % выхода годных на операциях сварки. На рынке сборки эта технология занимает 95%.
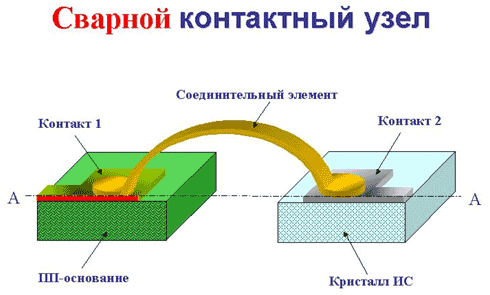
Рис.1 Технология «Wire Bond» на основе сварки
О достоинствах и недостатках способов на основе сварки можно говорить много (отработанность процессов, развитость инфраструктуры, высокий % выхода годных и т.п.).
Главное, что, несмотря на много лет развития, этот способ исчерпывает свои технико-экономические возможности при количестве контактов на чипе более 400:
- негрупповой характер технологии «Wire Bond» (операция сварки является последовательной процедурой) на основе сварки снижает производительность, % выхода годных и т.д. сборочных процедур, т.к. сварочное воздействие может вносить скрытые дефекты в сложные и хрупкие кристаллы ИС;
- невозможно разваривать контакты в рабочей области кристалла (термокомпрессионная сварка в этой области нарушает целостность «нежных» транзисторных структур), что резко снижает количество контактов ввода-вывода на кристалле (количество контактов, с заданным шагом, по периферии кристалла пропорционально линейным размерам кристалла, а по площади – квадрату линейных размеров).
Поэтому был необходим групповой способ сборки, обеспечивающий работу с матрицей контактов на кристалле, – и он появился в начале 60-х годов усилиями IBM и других компаний.
«Flip Chip»
Способ этот получил название флип-чип (Flip Chip – перевернутый кристалл), от технологии соединения, когда все контакты кристалла, «в один прием», присоединяются к ответным контактам на коммутационной подложке.
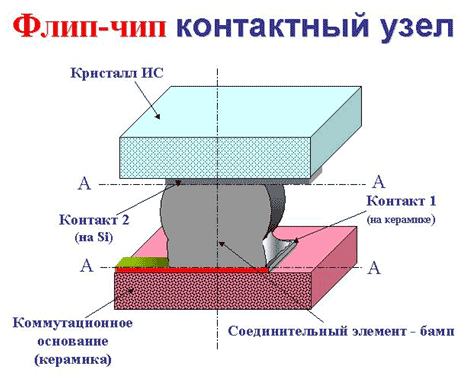
Рис.2 Технология «Flip Chip» (флип-чип)
Одним из преимуществ флип-чип-технологии (помимо группового характера сборки) является то, что можно монтировать кристаллы с матричным расположением контактов. Например, при координатной сетке 250 мкм, на 1 кв.см. чипа можно легко разместить до 40х40=1600 контактов, в то врем, как при периферийном расположении и при таком же шаге – только 40х4=160 контактов.
Однако, из-за присущих данному способу недостатков:
- сложность (высокая себестоимость) коммутационного основания (подложки) и
- низкие термомеханические характеристики при термоциклировании (монтажные шарики «катаются» между чипом и подложкой, имеющими различное тепловое расширение, пока не отваливаются),
доля flip-chip в сборке и корпусировании ИС за 40 лет внедрения составляет менее 5%. Несмотря на десятки миллиардов долларов вложений в инфраструктуру (материалы, оборудование и т.п.), этот способ сборки используют только IBM, Intel, AMD и еще несколько компаний.
Проведенное компьютерное моделирование так же показало, что деформации во флип-чип конструкции (для чипа 1 кв.см. со 40х40=1600 контактами) – от центра чипа к краю – достигают 300%. Если в зазор между чипом и подложкой залить специальную демпфирующую массу (underfill), то деформация уменьшается, но, все равно, достигает 100%.
Другие известные способы и технологии сборки еще более сложны и проблемны, чем Wire Bond и Flip Chip. Их вклад в мировую сборку мало отличается от нуля.
Сегодня все разработчики дружно двигаются в сторону создания на этих двух способах сборки (Wire Bond и Flip Chip) различных одно- и многокристальных конструкций, усугубляя все проблемы этих способов сборки.
Можно констатировать, что в 2003 г. для многовыводных чипов (с числом выводов более 400-600) не было дешевой и надежной технологии сборки МногоКристальных Модулей (МКМ), поскольку сварка – уже не могла, а флип-чип – все никак не мог дойти до массовой продукции.
Поэтому ситуация с реальными (коммерческими) многокристальными модулями на многовыводных чипах то накалялась (хотелось избавиться от последовательной процедуры разварки и дорогих многослойных коммутационных структур), то интерес к МКМ падал, что отражало отсутствие реальной коммерческой технологии сборки.
Технология капиллярной сборки А.И. Тарана
На основе анализа достоинств и недостатков двух описанных господствующих в отрасли способов сборки и, особенно, анализа конструкций Wire Bond и flip-chip контактных узлов, А.И. Тараном был разработан, создан и апробирован в России, а запатентован как в России, так и за рубежом, новый контактный узел (КУ), в котором пара контактов связана капиллярным соединительным элементом. Использование для сборки естественного физического эффекта сняло многие противоречия, проблемы и недостатки предыдущих конструкций КУ, породило новые конструктивно-технологические решения при конструировании и производстве дешевой плотноупакованной аппаратуры на современных сложных кристаллах ИС.
Анализ достоинств и недостатков такого фундаментального понятия, как контактный узел, в сборке привел к осознанию важного факта – любые такие узлы отличаются друг от друга:
1) расположением соединяемых контактов относительно друг друга (в сварном КУ контакт на чипе и ответный контакт на подложке разнесены в пространстве, а во флип-чип КУ – совмещены по вертикали и обращены друг к другу);
2) устройством соединительного элемента (для сварного КУ – это проволока, а для флип-чип – это монолитный выступ-шарик, например, из припоя).
Эти два обстоятельства привели, в случае сварного КУ к многомиллиардной индустрии и бизнесу, а в случае флип-чип КУ – к многомиллиардным затратам.
А.И. Тараном был разработан новый соединительный элемент и КУ на его основе, лишенные недостатков предыдущих конструкций.
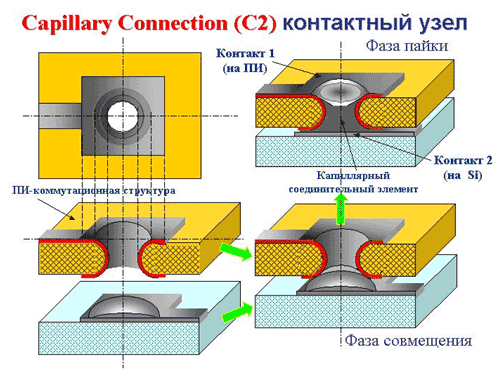
Рис.3 Соединительный узел и технология А.И. Тарана
Суть изобретения – в применении (в качестве соединительного элемента между контактами) металлизированного облуженного отверстия в слое диэлектрической пленки, которое, в процессе пайки, становится капилляром для припоя на контактах.
Такое устройство Соединительного Элемента (и Контактный Узел на его основе) обладало следующими достоинствами:
1) через отверстие можно было визуально позиционироваться, а также контролировать процесс и результат пайки (при флип-чип сборке кристалл и подложка закрывают всё и всё делается «вслепую»)
2) через отверстие выходили побочные продукты пайки
3) процесс был групповой (хоть один, хоть 10.000 КУ)
4) и самое главное – капиллярный эффект был столь силен, чем обеспечивал 100% выход годных КУ
5) кроме того, если на плоском контакте доза припоя была сформирована в виде выступа, хотя бы частично входящего в отверстие, то возникал эффект самосовмещения.
Данное решение КУ оказалось универсальным и одинаково эффективным:
- для монтажа чипа на пленочный коммутационный носитель;
- для сборки многослойных (и 20 слоев – не проблема!) полиимидных (и не только полиимидных) печатных плат высокого разрешения;
- для монтажа пленочных структур к твердому носителю (например, к печатной плате).
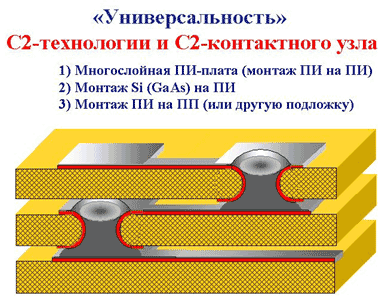
Рис.4 Многослойные полиимидные печатные платы. После монтажа эти платы их можно было сворачивать в трубочку или складывать, не нарушая целостности соединений.
Поэтому этот контактный узел был назван и запатентован, как Универсальный Контактный Узел (УКУ, по-английски – Universal Contact Unit - UCU).
Из идеи капиллярного соединительного элемента у А.И. Тарана возникла новая технология сборки в микроэлектронике (Capillary Connection Multi Chip Modules Technology = C2-MCM-techologyTM = С2-МКМ-технологияТМ) и, можно сказать, «забил фонтан» новых технических решений:
1) Конструкции КУ с капиллярным соединительным элементом;
2) Конструкции пленочных монтажно-коммутационных носителей чипов;
3) Конструкции многослойных печатных плат с уникальными характеристиками по разводимости;
4) Конструкции однокристальных модулей (ОКМ);
5) Конструкции планарных многокристальных модулей;
6) Конструкции этажерочных МКМ;
7) Конструкции 3-D МКМ;
8) Установки для сборки ОКМ и МКМ:
- для малых OEM-производителей ОКМ / МКМ аппаратуры;
- для крупносерийных производителей ОКМ / МКМ аппаратуры.
Фотографии тестовых образцов и прототипа сборочной машины приведены на рис. 5-7.

Рис.5

Рис. 6 С2-МКМ. 8 чипов х 400 контактов = 3200 контактов
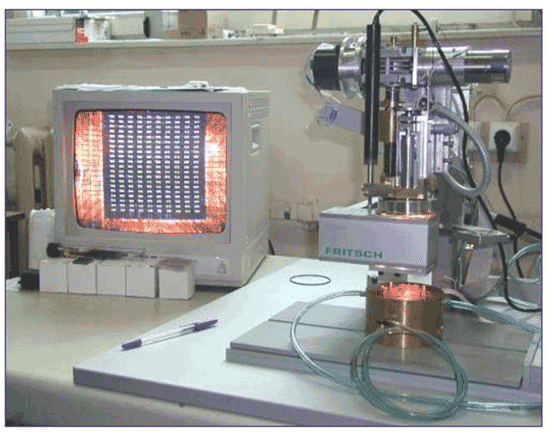
Рис.7. Прототип сборочной машины для С2-технологии
Анализ литературы и участие А.И. Тарана в мировых конференциях и выставках по проблемам сборки в микроэлектронике показали:
- мировую новизну решений;
- мировую исключительность (эксклюзивность) решений.
Только к 2003 году на разрабатываемую технологию им были получены:
– 4 российских патента,
– 4 Евразийских патента,
– 3 американских патента.
К моменту формирование проекта «МИССИЯ» А.И. Таран совместно со своими партнерами:
1) Сформировал экспериментальный маршрут для изготовления и испытания образцов ОКМ и МКМ.
2) Разработал и изготовил образцы:
- ОдноКристальный Модуль (ОКМ) на 1600 контактов,
- BGA-корпус для кристалла ИС на 400 контактов с матричным расположением,
- МКМ в конструктиве PC-card на восемь 400-контактных чипов (т.е. на 3200
первичных контактов).
3) Отработал МКМ-тестовые структуры на кремниевых чипах и провел подготовку к системной интеграции для двух стандартных конструктивов:
- PC-card,
- PC-104 (PC-104+).
4) Разработал конструкцию Типового Элемента Замены (ТЭЗ) для С2-МКМ-аппаратуры (модуль ТЭЗ-С2-МКМ: размеры ~50х50х5мм на 8 см2 АК, плотность сборки ~600см2 АК/литр) – Рис. 8.
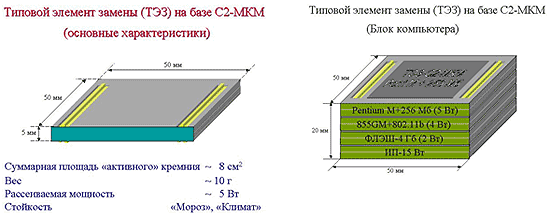
Рис. 8 Типовые Элементы Замены
5) Провел большой объем работ по компьютерному моделированию различных С2-МКМ-конструкций (в сравнении с флип-чип), которое показало большие преимущества новой технологии сборки (в технологичности, прочности и надежности).
6) По теме С2-МКМ сделал доклады на различных международных форумах сборочной индустрии в микроэлектронике:
- на мировой ежегодной конференции IMAPS-2000 (International Microelectronics and Packaging Society and Educational Foundation) в Бостоне (сентябрь 2000, с публикацией в Сборнике Трудов Конференции);
- на Конференции IMAPS-Europa-2000 в Праге, июнь 2000;
- на Конференции «Сборка в аппаратуре беспроводной связи» в Далласе, май 2002, с публикацией в Сборнике Трудов Конференции;
- на Конференции IMAPS-Europa-2002 в Варшаве, июнь 2002, с публикацией в Сборнике Трудов Конференции.
7) Провел презентации С2-МКМ-технологии в Silcon Vally (USA) на фирмах: HP, National Semiconduktor, XILINX, AMD и др.
Трудности перестройки уже отлаженных технологий, кризис в хай-тек индустрии, а так же твердое желание А.И. Тарана полностью не передавать технологию западным компаниям и реализовать ее в России в государственных интересах, не позволили осуществить ее внедрение в этих компаниях. Однако, со сборочной компанией iPAC (перечисленные выше фирмы были ее клиентами), расположенной в Silcon Vally (California, USA), было заключено предварительное лицензионное Соглашение, в рамках которого были в кратчайшие сроки:
- разработан (по спецификации iPAC) BGA-корпус для чипа 1 кв.см. на 400 контактов с матричным расположением,
- разработан и поставлен прототип сборочной машины.
Предстояло проведение (вместе с компанией iPAC) сборки партии образцов тестовых структур (1500 шт.) и их испытания по согласованной программе. Но, к сожалению, из-за мирового кризиса, начиная с 2002 г., в хай-тек индустрии сборочная компания iPAC была свернута (своей материнской компанией, расположенной на Тайване) и связи с ней А.И. Тарана прервались.
Тем не менее, проделанная работа (изготовление экспериментальных образцов, международное патентование, доклады на международных конференциях) и реакции специалистов в области сборки, позволило констатировать, что положено начало новому направлению сборки в микроэлектронике – С2-МКМ-технологияТМ.
С этой технологией и этими результатами А.И. Таран вошел в число создателей проекта «МИССИЯ». Это дало ему возможность после формулирование задач проекта разработать конструктив сборно-разборного блока плотноупакованной аппаратуры на базе ТЭЗ-С2-МКМ. Размеры блока ~10х10х10см (литр), плотность сборки ~600см2 АК/литр представлен на рис.9.
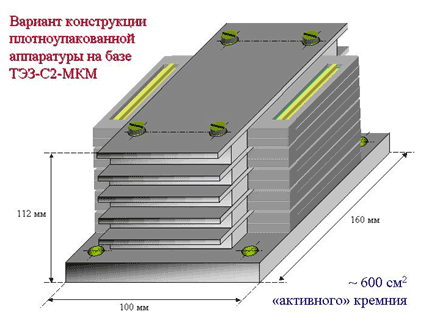
Рис. 9. ТЭЗ реконфигурируемого вычислительного модуля с однородно-вычислительной средой на 1 триллион операций в секунду.
Триллион операций почти в поллитре. И это 2003 год!
Что потеряла Россия
А.И. Тараном было открыто и экспериментально обосновано новое направление в сборке, которое существенно расширило возможности создания и производства массовой и недорогой аппаратуры с уникальными характеристиками.
Здесь нет надобности подробно рассказывать, сколько усилий А.И. Таран прикладывал для реализации этой технологии в России, где только и кому только он не делал презентации (от Совета Безопасности РФ и Министерства Обороны до Думы и Совета Федерации, от институтов РАН до множества инвестиционных компаний и фондов, декларирующих поддержку инновационного развития в России), которые, в конце-концов, подорвали его здоровье. Но, будучи даже человеком больным, он никогда не терял оптимизм, настойчивость и целеустремленность, показывая своим примером, как нужно добиваться поставленных целей. Его упорство – это подвиг ученого и изобретателя, который до последней минуты своей жизни стремился передать свою технологию отечественным предприятиям как гражданским, так и оборонным.
Подводя итог описанию технологии С2-МКМ проекта «МИССИЯ», хочу подчеркнуть, что еще в 2003 году капиллярная технология сборки А.И. Тарана позволяла:
- увеличить плотность сборки на 2-3 порядка (относительно традиционной аппаратуры), а значит, резко снизить массогабаритные характеристики и материалоемкость аппаратуры;
- создавать сборно-разборные конструкции аппаратуры на 600-800 см2 «активного» кремния в 1 литре объема;
- значительно увеличить % выхода годных при сборке;
- применять в малогабаритной аппаратуре многовыводные БИС (до 2 тыс. контактов на см2 кристалла);
- резко повысить надежность аппаратуры, стойкость к термо-механическим нагрузкам и внешним воздействиям, в том числе к электромагнитному воздействию;
- улучшить характеристики теплоотвода и условий питания интегральных схем;
- поднять тактовые частоты электронной аппаратуры в ГГ-цовую область и улучшить электродинамические характеристики межкристального обмена;
- снизить токопотребление аппаратуры;
- существенно снизить себестоимость аппаратуры;
- реализовать концепцию «расходуемой избыточности» при создании отказоустойчивой необслуживаемой и бортовой аппаратуры;
- создавать мобильные суперкомпьютеры;
- создавать массовую электронную аппаратуру с уникальными характеристиками для мобильных применений;
- и т.д.
Вот, что потеряла Россия и от чего она отказалась.
И не известно, что является по отношению к интересам России большим преступлением: воровство в «Рособоронсервисе» или бездействие по внедрению таких технологий.
Банально, что нет пророка в своем Отечестве. Печально, когда такое Отечество – Россия. Больно, что такое Отечество, скорее всего, одно на всем белом свете.
Статья подготовлена с использованием материалов А.И. Тарана
Одна из презентаций МКМ технологии в формате PPS (1189Кб)
В.Ю. Татур, Микроэлектроника Александра Тарана // «Академия Тринитаризма», М.,
|
|